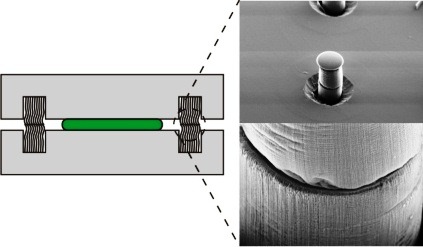
研究人員用碳奈米管填充兩顆以TSV穿孔的矽晶片孔洞,然後用黏著劑貼合兩片晶片,碳奈米管因此直接接觸;右方是接合處的放大圖
來自瑞典哥德堡(Gothenburg)的查默斯理工大學(Chalmers University of Technology)的研究人員發現,以碳奈米管來填充採用矽穿孔技術(TSV)連結的 3D晶片堆疊,效果會比銅來得更好。
TSV是將晶片以3D堆疊方式形成一個系統,而非將它們平行排列在電路板上,以提高晶片之間通訊的速度;但遺憾的是,目前用以填充矽晶孔洞的銅,卻會導致熱膨脹(thermal expansion)的問題,因為銅遇熱會比週圍的矽材料膨脹更多。
「碳奈米管的許多特性都優於銅,包括熱膨脹係數與電子傳導性;」查默斯理工大學研究團隊成員Kjell Jeppsson表示:「碳奈米管的熱膨脹係數與週遭的矽差不多,但銅的膨脹係數較高,會產生足以導致元件破損的機械張力(mechanical tension)。」該研究團隊成員還包括Teng Wang與 Johan Liu。
此外與銅相較,奈米管的傳導性更高、重量更輕,製造程序也比碳薄膜(也就是石墨烯)簡單;為了證實其研究觀點,查默斯理工大學的研究團隊最近做了一個實驗,將兩顆晶片打孔,再以碳奈米管填充矽晶片孔洞,並用黏著劑將晶片堆疊起來,結果發現兩種材料在電子傳導性表現與熱膨脹方面都能良好結合。
不過以碳奈米管填充TSV製程3D矽晶片孔洞的這個方法,要達到量產還需要克服的一個障礙,就是製程的溫度:碳奈米管通常在攝氏700度之下進行生產,但CMOS晶片在超過攝氏450度的環境下就會受損;如果這個問題可以解決──例如以獨立製程生產奈米管,再以機械方法進行填充──而研究人員預期他們開發的技術能在5年內商業化。
編譯:Judith Cheng
(參考原文: Researchers: Carbon better than copper for TSVs,by R. Colin Johnson)



 留言列表
留言列表